Всем доброго времени суток. В прошлой статье я рассказывал о полупроводниках, их структуре и характере работы. На основе полупроводников создаются разнообразны электронные компоненты: диоды, тиристоры, транзисторы, интегральные микросхемы. В основе их работы лежит электронно-дырочный переход. Наиболее часто применяются переходы, образованные двумя соседними областями полупроводника, первая имеет проводимость p-типа, а вторая – n-типа. Такой электронно-дырочный переход называется p-n-переходом. Кроме него встречаются электронно-дырочные переходы между полупроводником и металлическим контактом – барьер Шоттки. В данной статье я рассмотрю p-n-переход.
Для сборки радиоэлектронного устройства можно преобрески DIY KIT набор по ссылке.
Типы электронно-дырочных переходов
Электронно-дырочный переход является основой большинства полупроводниковых приборов, предназначенных для усиления и преобразования сигналов. Электронно-дырочный переход образуется в целом монокристалле полупроводника, у которого одна область легирована донорной примесью, а другая – акцепторной. Границей раздела этих двух областей с разным типом проводимости называется электронно-дырочный переход.
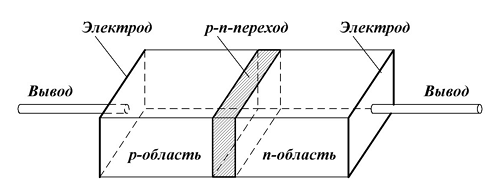
Электронно-дырочный p-n-переход.
Электронно-дырочные переходы, применяемые в полупроводниковой промышленности, в зависимости от своего типа, бывают плоскостными, точечными и поверхностно-барьерными.
Плоскостной переход образуется на границе раздела двух областей с разными типами проводимости. Чаще всего применяется электронно-дырочный переход между областями с p-проводимостью и n-проводимостью. Также встречаются электронно-электронный переход (n+-n-переход) и дырочно-дырочный переход (p+-p-переход). Данные переходы образуются в полупроводниках n-типа и p-типа соответственно с разной электрической проводимостью. Знак «+» указывает область с большим значением электропроводности.
Точечный электронно-дырочный переход формируется между полупроводниковым кристаллом и иглой прижимного контакта. Полупроводниковые приборы на основе точечных переходов были исторически первыми, но в настоящее время практически не применяются из-за низкой механической прочности и плохой воспроизводимой параметров.
Поверхностно-барьерный электронно-дырочный переход образуется между полупроводником и инверсным слоем, возникающим на поверхности кристалла соответствующей технологической обработкой.
Методы изготовления p-n-переходов
Создать p-n-переход нельзя простым соединением пластин с p- и n-типом проводимостей, так как неизбежно появления даже микроскопического воздушного или поверхностного слоя, что негативно скажется на его свойствах. Поэтому их изготавливают особыми металлургическими способами.
- Выращенные переходы, получаемые при выращивании монокристалла из расплава путём добавления примесей донорных и акцепторных элементов. Это исторически первый способ получения p-n-переходов и в настоящее время не используется.
- Сплавные переходы, получаемые путём вплавления примесей в монокристалл полупроводника. К примеру, на пластинке полупроводника n-типа помещается небольшая таблетка из примесного элемента III группы (например, индия — In). Затем производят нагрев выше температуры плавления примесного элемента. В результате наплавления примеси образуется слой p-типа, который с полупроводником n-типа формирует p-n-переход.
- Диффузионный переход, формируется путём диффузии соответствующей примеси в исходную полупроводниковую пластину. Диффузия может происходить двумя способами: из внутренних областей кристалла из жидкой фазы (диффузия из расплава); через поверхность кристалла от внешних источников (диффузия из газовой среды).
Чаще всего диффузия происходит из газовой среды через маску из оксидной плёнки, под которой образуется переход. При этом фотолитография происходит в следующем порядке: вначале наносится слой фоторезиста, затем засвечивают через фотошаблон конфигурацию рисунков и проявляют для удаления не засвеченных участков оксидного слоя. Через вскрывшиеся «окна» в оксидном слое производят диффузию примесей и получают p-n-переходы.
- Эпитаксиальный переход, получают путём наращивания монокристаллической полупроводниковой плёнки на полупроводниковую подложку требуемой проводимости. Например, на подложку из полупроводника p-типа наращивают плёнку n-типа и получают p-n-переход.
- Ионное легирование. При этом способе получения p-n-переходов, примесный материал бомбардируют при помощи ускорителя и магнитной сепарации выделяя требуемую примесь. Глубина проникновения ионов примеси в полупроводник определяется энергией в ускорителе, а степень легирования – временем бомбардировки.
- Электрохимический способ создания p-n-переходов заключается в следующем. На полупроводниковой пластине электрохимическим способом вытравливают небольшие углубления с размерами, определяющими размеры p-n-перехода. Затем электролитическим осаждением наращивают полупроводник требуемой проводимости.
В зависимости от способа создания p-n-перехода он имеет разную структуру:
— классическая структура, представляет собой слои полупроводника с разным типом проводимости, чередующиеся друг за другом. Такие структуры характерны для выращенных, и сплавных p-n-переходов;
— мезаструктура образуется, когда пассивные участи кристалла вытравливаются, с целью исключения паразитных эффектов, повышения напряжения поверхностного пробоя, уменьшения ёмкости p-n-перехода. Полупроводниковая пластинка вытравливается таким образом, что отдельные слои возвышаются на подложкой;
— планарная структура получается, когда p-n-переход формируется путём газовой диффузии. При этом переходы образуются под оксидным слоем и поэтому отсутствуют аномальные эффекты, связанные с выходом p-n-переходов на поверхность.
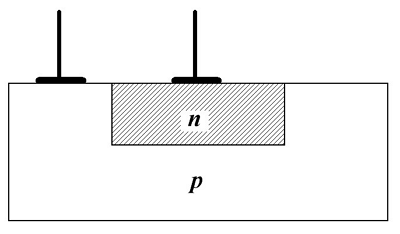
p-n-переход с планарной структурой.
В p-n-переходе происходит движение носителей заряда, в зависимости от механизма их движения переходя можно разделить на дрейфовые и диффузионные.
Для диффузионных p-n-переходов характерно равномерное распределение примесей в полупроводнике и в результате не образовываются внутренние электрические поля. При этом направленные потоки неосновных носителей заряд, из участков с большей концентрацией к участкам с меньшей концентрацией, образуются благодаря диффузии.
Для дрейфовых p-n-переходов характерно образование неравномерных участков с примесями, что приводит к более быстрому перемещению неосновных носителей заряда участка с повышенной концентрацией неосновных носителей заряда. Дрейфовый p-n-переход характерен для диффузионного метода изготовления перехода.
Структура p-n-перехода
Как указывалось выше, образование p-n-перехода связано со сложными технологическими процессами, в течении которых в полупроводник вносятся примеси различного типа. Свойства полученных материалов лежат в основе полупроводниковых приборов и интегральных микросхем.
Рассмотрим структуру p-n-перехода. Для образования настоящего перехода в полупроводнике необходимо добиться достаточно резкой границы между p- и n-слоями, а также переход должен быть несимметричен. Под резкостью границы между слоями, подразумевается скачкообразное уменьшение концентрации акцепторов Na в р-слое и скачкообразное возрастание доноров Nд в n-слое на некотором промежутке. Данный промежуток равен глубине проникновения электрического поля в полупроводник или глубине экранирования и носит название дебаевской длины в собственном полупроводнике lDi. Для германия она составляет порядка lDi ≈ 0,6 мкм, а для кремния порядка lDi ≈ 20 мкм.
Несимметричность p-n-перехода состоит в том, что концентрация основных носителей в слоях (дырок в р-слое рр и электронов в n-слое nn) различно, то есть выполняется неравенство
причем концентрация должна различаться на несколько порядков. Концентрация акцепторных Nа и донорных Nд примесей и свободных носителей заряда pp и nn в каждом из слоёв показана ниже

Структура p-n-перехода:
слева – начальное состояние слоёв; справа – пространственные заряды в p-n-переходе.
Так как концентрация дырок в р-слое значительно больше, чем в n-слое (pp > pn), а электронов в n-слое больше, чем в р-слое (nn > np), то происходит диффузия дырок в область n-типа, а электронов в область р-типа.
После того как электрон покинет n-область в ней образуется нескомпенсированный положительный заряд донорной примеси, а в р-области после покидания её дырки – отрицательный заряд акцепторной примеси. Кроме того, нескомпенсированные заряды образуются в результате перемещения и рекомбинации свободных носителей зарядов примесей в данных областях. В результате данных процессов на границе р- и n-областей образуется двойной объёмный слой пространственных зарядов, который называется p-n-переходом. Данный объёмный слой из-за уменьшенной концентрации свободных носителей зарядов имеет более высокое удельное сопротивление по сравнению с р- и n-областями и поэтому называется обеднённым или запирающим. Однако, концентрация свободных носителей заряда р-n-переходе уменьшается плавно, и, поэтому запирающий слой уже p-n-перехода.
Пространственные заряды в p-n-переходе образуют своё электрическое поле, которое ограничивает диффузию. Для прохождения области пространственных зарядов электрону или дырке необходимо преодолеть потенциальный барьер, равный контактной разности потенциалов:
где k – постоянная Больцмана, k = 1,37 * 10-23 Дж/℃;
e – заряд электрона, e = 1,6*10-19 Кл;
Т – абсолютная температура, К;
Na и Nд – концентрация акцепторов и доноров в дырочной и электронной областях,
pp и pn – концентрация дырок в р- и n-слоях,
ni – собственная концентрация, для кремния ni ≈ 2*1010 см-3, для германия ni ≈ 2,5*1013 см-3.
Величина потенциального барьера p-n-переходов, созданных в германии, составляет 0,3…0,4 В, а созданных в кремнии, составляет 0,7…0,8 В.
Толщина несимметричного резкого p-n-перехода рассчитывается по формуле
где ε – относительная диэлектрическая постоянная материала полупроводника,
ε0 – диэлектрическая проницаемость вакуума, ε0 ≈ 8,85 * 10-12 Ф/м.
Токи в полупроводниках
Дырки и электроны в кристалле полупроводников совершают постоянные хаотические движения. При создании в нём электрического поля возникает направленное движение носителей заряда, вследствие действия данного поля. Таким образом, электроны и дырки начинают движение в кристалле, то есть возникает электрический ток, называемым дрейфовым током.
При своем направленном движении электроны постоянно сталкиваются с атомами кристаллической решётки, что приводит к некоторому изменению скорости движения, однако существует некоторая средняя скорость движения электронов vn в полупроводнике описываемая следующей формулой
где е – заряд электрона, е = 1,6*10-19 Кл,
μn – подвижность электронов,
tn – среднее время движения электронов,
mn – эффективная масса электронов, в относительных единицах. mn(Si) = 0,33, mn(Ge) = 0,22, mn(GaAs) = 0,07, mn(InSb) = 0,013.
Как показывают измерения, при комнатной температуре подвижность электронов для основных полупроводников составляет, для германия (Ge) – 3900 см2/(В*с), а для кремния (Si) – 1400 см2/(В*с). С увеличением температуры подвижность электронов уменьшается и может быть определена по следующим эмпирическим выражениям
Движение дырок μр в полупроводнике значительно ниже подвижности электронов. Так для кремния она составляет – 430 см2/(В*с2), а для германия – 1900 см2/(В*с2). Для учёта влияния температуры также выведены эмпирические выражения
Плотность дрейфового тока для электронов Jn др и для дырок Jp др определяются следующими формулами
где n и p – концентрация электронов и дырок соответственно.
Соответственно суммарная плотность дрейфового тока составит
Электрический ток в полупроводниках возникает не только из-за электрического поля, но и из-за разности концентраций подвижных носителей заряда в кристалле полупроводника. Так в соответствии с законами термодинамики, из области с высокой концентрацией микрочастиц в область с низкой концентрацией возникнет их диффузия, причём плотность диффузионного тока будет пропорциональна разности между концентрациями в этих двух областях.
Плотность диффузионного тока электронов выражается следующим дифференциальным выражением
где Dn – коэффициент диффузии электронов, для германия Dn = 93 см2/с, а для кремния Dn = 31 см2/с,
dn/dx – градиент концентрации электронов в кристалле полупроводника.
Аналогичное выражение существует для плотности диффузионного тока дырок
где Dр – коэффициент диффузии дырок, для германия Dр = 44 см2/с, а для кремния Dn = 65 см2/с,
dр/dx – градиент концентрации дырок.
Знак «-» в выражении показывает, что диффузионный ток дырок направлен в сторону уменьшения их концентрации.
При работе в полупроводниках может существовать, как дрейфовый, так и диффузионный ток. Поэтому общие выражения плотности токов будут иметь вид
Протекание тока через электронно-дырочный переход
При отсутствии внешнего электрического поля электрический ток полупроводнике должен отсутствовать, то есть равен нулю. То есть диффузионный ток в p-n-переходе, вызываемый различной концентрацией носителей заряда в кристалле, должен уравновешиваться дрейфовым током, направленным в противоположную сторону, и вызываемым напряжённостью внутреннего электрического поля Е
То есть разница в концентрации носителей заряда в полупроводнике существует всегда, что обусловлено существенным различием электрофизических свойств p-n-перехода от прилегающих к нему областей с p- и n-проводимостями.
Рассмотрим, как себя ведёт электронно-дырочный p-n-переход при прикладывании к нему внешнего электрического поля.
Допустим, внешнее электрического поле приложено плюсом к p-области, а минусом к n-области, то есть в данном случае оно противоположно по знаку контактной разности потенциалов.
Так как концентрация подвижных носителей заряда внутри p-n-перехода значительно ниже, чем в p- и n-областях, то сопротивление перехода значительно больше сопротивлений этих областей, поэтому большая часть напряжения падает на p-n-переходе величиной
где φК – контактная разность потенциалов,
U – приложенное напряжение к полупроводниковому кристаллу.
Так как внешнее электрическое поле направленно противоположно внутреннему электрическому полю p-n-перехода, то результирующие электрическое поле уменьшается. В результате этого происходит нарушение равновесия между дрейфовым и диффузионным токами, дрейфовый ток становится меньше, а результирующий ток будет не равен нулю
Электрический ток, протекающий через p-n-переход, в этом случае называется прямым током, а напряжение, приложенное к переходу, — прямым напряжением.
Толщина p-n-перехода, через который протекает прямой ток уменьшается, при этом уменьшается и сопротивление перехода согласно выражению
Диффузия дырок через p-n-переход, смещённый в прямом направлении, вызывает увеличение их концентрации на границе перехода. При этом увеличившаяся концентрация дырок вызывает дальнейшее диффузионное проникновение их вглубь n-области, где они не являются основными носителями заряда. Данный эффект называется инжекцией носителей заряда.
При прикладывании напряжения плюсом к n-области, а минусом – к p-области, оно совпадает по знаку с контактной разностью потенциалов. Так как сопротивление p-n-перехода значительно выше областей с p- и n-проводимостью, то практически всё напряжение оказывается приложенным к переходу
где φК – контактная разность потенциалов,
U – приложенное напряжение к полупроводниковому кристаллу.
Так как напряжение на переходе возрастает, то и толщина перехода также увеличивается согласно выражению
Внутреннее электрическое поле и внешнее приложенное складываются, что приводит к уменьшению диффузионного тока и дрейфовый ток начинает преобладать, и, следовательно, ток через переход не будет иметь нулевого значения
Так как результирующий ток противоположен по направлению прямому току, то его называют обратным током, а напряжение его вызывающее, — обратным напряжением.
Под действием обратного тока возникает диффузия неосновных носителей заряда к границе перехода, где они под действием электрического поля переносятся через p-n-переход. Данный эффект называется экстракцией носителей заряда.
Вольт-амперная характеристика p-n-перехода
Вольт-амперной характеристикой (ВАХ) p-n-перехода называется зависимость тока, протекающего через него от приложенного к нему напряжения I = f(U).
Величина, протекающего через p-n-переход тока зависит от плотности тока и площади поперечного сечения самого перехода S. Как было указано выше плотность тока через переход является суммой плотностей электронного и дырочного токов
Данные выражения можно упростить, зная, что напряженность электрического поля за пределами перехода практически равна нулю Е ≈ 0. Для избавления от дифференциала определим градиент концентрации носителей заряда d/dx, который для дырок на расстоянии х от границы p-n-перехода составит
где Lp – диффузионная длина дырок в n-области; то есть расстояние, на котором концентрация носителей заряда убывает в 2,7 раза. Для германия 0,7…2 мм, для кремния 0,2…0,6 мм. Тогда плотность диффузионного тока дырок в n-области составит
То есть диффузионный ток дырок в n-области от границы перехода уменьшается по экспоненциальному закону. Но в тоже время в р-области инжекционный ток дырок возрастает по экспоненте, то есть через p-n-переход величина дырочного тока остается неизменной и равной току инжекции дырок на границе перехода (х = 0). Кроме того, концентрация неосновных носителей заряда на границе перехода (для дырок р0) зависит от напряжения согласно следующей формуле
где р0 – концентрация дырок на границе перехода с р-областью,
рn – концентрация дырок в n-области,
n0 – концентрация электронов на границе с n-областью,
np – концентрация электронов в р-области,
φТ – температурный потенциал.
Тогда итоговое выражение для плотности дырочного тока будет иметь вид
Аналогичные рассуждения приводят к выражению для электронного тока через p-n-переход, которое будет иметь следующий вид
где Ln – диффузионная длина электронов в р-области. Для германия она составит Ln(Ge) = 1…3 мм, а для кремния Ln(Si) = 0,4…1 мм.
Тогда ток, проходящий через p-n-переход, имеющий площадь поперечного сечения S составит
где I0 – обратный ток p-n-перехода, или ток экстракции, вызванный неосновными носителями заряда и имеющий очень малое значение.
Вольт-амперная характеристика построенная в соответствии с данным выражением построена ниже

Вольт-амперная характеристика p-n-перехода.
При температуре Т = 300 К величина температурного потенциала составляет около 0,025 В, поэтому уже при небольшом напряжении U ток через p-n-переход достигает значительных величин. При подаче обратного напряжения ток, изменит своё направление и быстро достигнет величины I0 и дальше остаётся постоянным не зависимо от величины приложенного напряжения.
В следующей статье рассмотрю применение и свойства p-n-перехода в различных типах диодов.
Теория это хорошо, но необходимо отрабатывать это всё практически ПОПРОБОВАТЬ МОЖНО ЗДЕСЬ

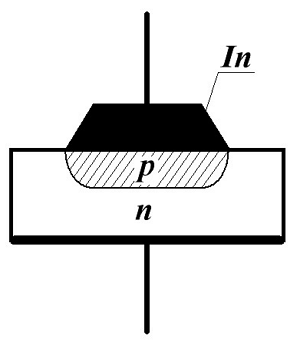

















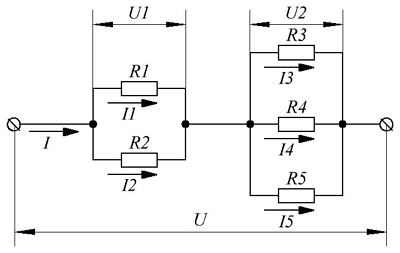 Электротехника часть 4. Соединение элементов цепи
Электротехника часть 4. Соединение элементов цепи Как рассчитать индуктивность катушек с замкнутыми сердечниками? Часть 2.
Как рассчитать индуктивность катушек с замкнутыми сердечниками? Часть 2.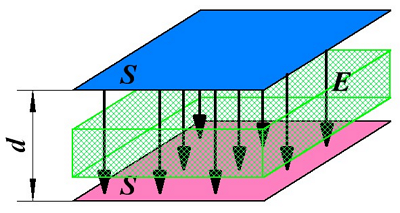 Принцип работы и устройство конденсатора
Принцип работы и устройство конденсатора Полупроводники.
Полупроводники.